Nguồn:https://link.springer.com/chapter/10.1007/978-3-319-48933-9_13
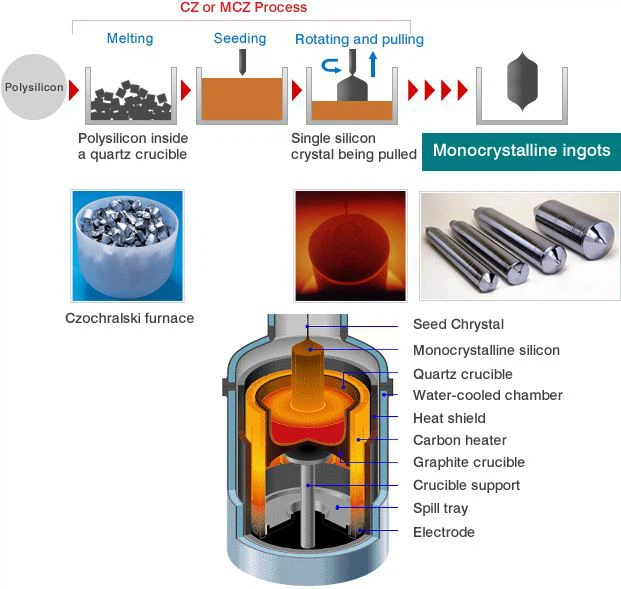
Silicon, đã, đang và sẽ tiếp tục là vật liệu thống trị trong ngành công nghiệp bán dẫn trong một thời gian tới [13.1], sẽ đưa chúng ta vào kỷ nguyên tích hợp quy mô cực lớn (ULSI) và kỷ nguyên hệ thống-ona-chip (SOC).
Khi các thiết bị điện tử ngày càng trở nên tiên tiến hơn, hiệu suất của thiết bị trở nên nhạy cảm hơn với chất lượng và đặc tính của vật liệu được sử dụng để cấu tạo chúng.
Gecmani (Ge) ban đầu được sử dụng làm vật liệu asemicond dẫn cho các thiết bị điện tử trạng thái rắn. Tuy nhiên, dải tần hẹp (0,66 eV) của Ge giới hạn hoạt động của các thiết bị dựa trên gecmani ở nhiệt độ xấp xỉ 90∘C vì dòng rò đáng kể quan sát được ở nhiệt độ cao hơn. Mặt khác, dải băng rộng hơn của silicon (1,12 eV), dẫn đến các thiết bị điện tử có khả năng hoạt động ở mức tối đa. Tuy nhiên, có một vấn đề nghiêm trọng hơn so với dải băng hẹp: gecmani không dễ dàng cung cấp lớp thụ động đáng kinh ngạc trên bề mặt. Ví dụ, germani dioxide (GeO2) hòa tan trong nước và phân ly ở khoảng 800∘C. Silic, trái ngược với gecmani, dễ dàng tạo ra sự thụ động bề mặt bằng cách tạo ra silic điôxít (SiO2), cung cấp mức độ bảo vệ cao cho thiết bị bên dưới. SiO ổn định này2lớp dẫn đến lợi thế đặc biệt cho silicon so với gecmani là vật liệu bán dẫn cơ bản được sử dụng để chế tạo thiết bị điện tử. Lợi thế này đã dẫn đến một số công nghệ mới, bao gồm các quy trình pha tạp khuếch tán và xác định các mẫu phức tạp. Các ưu điểm khác của silicon là nó hoàn toàn không độc hại, và silica đó (SiO2), nguyên liệu thô mà từ đó silicon thu được, bao gồm khoảng 60%thành phần khoáng chất của vỏ Trái đất. Điều này ngụ ý rằng nguyên liệu thô mà từ đó silicon thu được có sẵn trong nguồn cung cấp dồi dào cho mạch tích hợp (Vi mạch) ngành. Hơn nữa, silicon cấp điện tử có thể thu được với giá rẻ hơn một phần mười so với gecmani. Tất cả những ưu điểm này đã khiến silicon gần như thay thế hoàn toàn gecmani trong công nghiệp bán dẫn.
Mặc dù silicon không phải là sự lựa chọn tối ưu cho mọi thiết bị điện tử, nhưng lợi thế của nó có nghĩa là nó gần như chắc chắn sẽ thống trị ngành công nghiệp bán dẫn trong một thời gian.
Những tương tác rất hiệu quả đã xảy ra giữa người dùng và nhà sản xuất vật liệu bán dẫn kể từ khi phát minh ra bóng bán dẫn tiếp xúc điểm vào năm 1947, khi nhu cầu vềhoàn hảo và tinh khiếttinh thể đã được công nhận. Sự cạnh tranh thường đến mức chất lượng tinh thể yêu cầu của các thiết bị mới chỉ có thể được đáp ứng bằng cách kiểm soát sự phát triển tinh thể bằng cách sử dụng thiết bị điện tử được chế tạo với các thiết bị mới này. Kể từ khi các tinh thể silicon không bị trật khớp đã được phát triển ngay từ những năm 1960 bằng cách sử dụngKỹ thuật dấu gạch ngang[13.2], các nỗ lực nghiên cứu và phát triển vật liệu bán dẫn đã tập trung vào độ tinh khiết của vật liệu, năng suất sản xuất và các vấn đề liên quan đến sản xuất thiết bị. Sơ đồ dòng cho các quá trình điều chế silicon bán dẫn điển hình. (Sau[13.1]) Chip trên mỗi wafer như một chức năng của quá trình tạo DRAM. (Sau[13.3]) Trong chương này, các phương pháp tiếp cận hiện tại để điều chế silicon - chuyển đổi nguyên liệu thô thành silicon đơn tinh thể (xem Hình.13.1) - được thảo luận. Bước tiếp theo là tinh chế MG-Si đến mức silicon bán dẫn (SG-Si), được sử dụng làm nguyên liệu ban đầu cho silicon đơn tinh thể. Khái niệm cơ bản là MG-Si dạng bột được phản ứng với HCl khan để tạo thành các hợp chất clorosilan khác nhau trong lò phản ứng tầng afluidized. Sau đó, các silan được tinh chế bằng cách chưng cất và lắng đọng hơi hóa học (CVD) để tạo thành SG-polysilicon. 1. Nó có thể dễ dàng được hình thành bằng phản ứng của hydro clorua khan với MG-Si ở nhiệt độ hợp lý thấp (200-400∘C). 2. Nó là chất lỏng ở nhiệt độ phòng, vì vậy việc tinh chế có thể được thực hiện bằng cách sử dụng các kỹ thuật chưng cất tiêu chuẩn. 3. Nó rất dễ xử lý và có thể được lưu trữ trong các thùng thép cacbon khi khô. 4. Trichlorosilan lỏng dễ hóa hơi và khi trộn với hydro, nó có thể được vận chuyển trong các dây chuyền thép. 5. Nó có thể bị giảm ở áp suất khí quyển khi có mặt hydro. 6. Sự lắng đọng của nó có thể diễn ra trên silicon được nung nóng, loại bỏ nhu cầu tiếp xúc với bất kỳ bề mặt lạ nào có thể làm ô nhiễm silicon tạo thành. 7. Nó phản ứng ở nhiệt độ thấp hơn (1000–1200∘C) và với tốc độ nhanh hơn silic tetraclorua. Không cần phải nói, độ tinh khiết của các thanh mảnh phải tương đương với độ tinh khiết của silicon lắng đọng. Các thanh mỏng được làm nóng trước đến khoảng 400∘C khi bắt đầu quá trình CVD silicon. Quá trình gia nhiệt sơ bộ này là cần thiết để tăng độ dẫn của các thanh mảnh có độ tinh khiết cao (điện trở cao) đủ để cho phép gia nhiệt bằng điện trở. Đặt cọc trong 200–300 giờ vào khoảng 11 giờ∘C tạo ra các thanh polysilicon có độ tinh khiết cao có đường kính từ 150–200 mm. Các thanh polysilicon được định hình thành nhiều dạng khác nhau cho các quá trình phát triển tinh thể tiếp theo, chẳng hạn như các khối để tăng trưởng nóng chảy Czochralski và các thanh hình trụ dài để phát triển vùng nổi. Quá trình khử trichlorosilane trên thanh silicon nung nóng bằng cách sử dụng hydro được mô tả vào cuối những năm 1950 và đầu những năm 1960 trong một số bằng sáng chế về quy trình được giao cho Siemens; do đó, quá trình này thường được gọi làPhương pháp Siemens[13.4]. Những nhược điểm chính của phương pháp Siemens là hiệu quả chuyển đổi silic và clo kém, kích thước lô tương đối nhỏ và tiêu thụ điện năng cao. Hiệu suất chuyển đổi kém của silic và clo có liên quan đến khối lượng lớn silic tetraclorua được tạo ra như sản phẩm phụ trong quá trình CVD. Chỉ khoảng 30%của silicon được cung cấp trong phản ứng CVD được chuyển thành polysilicon có độ tinh khiết cao. Ngoài ra, chi phí sản xuất polysilicon có độ tinh khiết cao có thể phụ thuộc vào tính hữu dụng của sản phẩm phụ, SiCl4. Công nghệ sản xuất Apolysilicon trên cơ sở sản xuất và nhiệt phân monosilan được thành lập vào cuối những năm 1960. Monosilan có khả năng tiết kiệm năng lượng vì nó lắng đọng polysilicon ở nhiệt độ thấp hơn và tạo ra polysilicon tinh khiết hơn so với quá trình trichlorosilan; tuy nhiên, nó hầu như không được sử dụng do thiếu một con đường kinh tế đến monosilane và do các vấn đề xử lý ở bước lắng đọng [13.5]. Tuy nhiên, với sự phát triển gần đây của các tuyến đường kinh tế đến silan có độ tinh khiết cao và việc vận hành thành công nhà máy quy mô báo động, công nghệ này đã thu hút sự chú ý của ngành công nghiệp bán dẫn, vốn đòi hỏi silicon có độ tinh khiết cao hơn. Trong các quy trình monosilan công nghiệp hiện tại, bột magiê và MG-Si được nung nóng đến 500∘C trong môi trường ahydrogen để tổng hợp magenesium silicide (Mg2Si), sau đó được tạo ra để phản ứng với amoni clorua (NH4Cl) trong amoniac lỏng (NH3) dưới 0∘C để tạo thành monosilan (SiH4). Sau đó, polysilicon có độ tinh khiết cao được sản xuất thông qua nhiệt phân monosilan trên các sợi polysilicon được làm nóng bằng điện trở ở 700–800∘C. Trong quá trình tạo monosilan, hầu hết các tạp chất bo được loại bỏ khỏi silan thông qua phản ứng hóa học với NH3. Hàm lượng Aboron 0,01–0,02 ppba trong polysilicon đã đạt được bằng cách sử dụng quy trình amonosilane. Nồng độ này rất thấp so với nồng độ quan sát được trong polysilicon được điều chế từ trichlorosilan. Hơn nữa, polysilicon tạo thành ít bị ô nhiễm với các kim loại được lấy qua quá trình vận chuyển hóa học vì sự phân hủy monosilan không gây ra bất kỳ vấn đề ăn mòn nào. Quá trình khác biệt đáng kể, sử dụng sự phân hủy monosilan trong lò phản ứng lắng đọng tầng afluid hóa để tạo ra polysilicon dạng hạt chảy tự do, đã được phát triển [13.5]. Các hạt hạt silic nhỏ bé được sôi trong hỗn hợp amonosilan ∕ hydro, và polysilicon được lắng đọng để tạo thành các hạt hình cầu chảy tự do có đường kính trung bình 700 μm với phân bố kích thước 100–1500 μm. Các hạt tầng sôi ban đầu được tạo ra bằng cách nghiền SG-Si trong máy nghiền aball hoặc búa và rửa sản phẩm bằng axit, hydro peroxit và nước. Quá trình này tốn nhiều thời gian và chi phí, và có xu hướng đưa các tạp chất không mong muốn vào hệ thống thông qua máy mài kim loại. Tuy nhiên, trong phương pháp mới, các hạt SG-Si lớn được bắn vào nhau bởi dòng khí tốc độ cao khiến chúng bị vỡ thành các hạt có kích thước không phù hợp với tầng sôi. Quá trình này không sử dụng vật liệu lạ và không cần rửa trôi. Do diện tích bề mặt của polysilicon dạng hạt lớn hơn, các lò phản ứng tầng sôi hiệu quả hơn nhiều so với các lò phản ứng dạng que truyền thống của Siemens. Chất lượng của polysilicon tầng sôi đã được chứng minh là tương đương với polysilicon được sản xuất bằng phương pháp Siemens thông thường hơn. Hơn nữa, polysilicon dạng hạt ở dạng không chảy và mật độ khối cao cho phép người trồng tinh thể thu được nhiều nhất từ mỗi lần sản xuất. Nghĩa là, trong quá trình tăng trưởng tinh thể Czochralski (xem phần sau), các chén nung có thể được làm đầy nhanh chóng và dễ dàng để có tải trọng đồng đều, thường vượt quá tải trọng của các khối polysilicon xếp chồng lên nhau một cách ngẫu nhiên được sản xuất theo phương pháp Siemens. Nếu chúng ta cũng xem xét tiềm năng của kỹ thuật để chuyển từ hoạt động hàng loạt sang kéo liên tục (sẽ được thảo luận ở phần sau), chúng ta có thể thấy rằng các hạt polysilicon chảy tự do có thể cung cấp tuyến đường thuận lợi của nguồn cấp dữ liệu auniform vào trạng thái nóng chảy ổn định. Sản phẩm này dường như là vật liệu khởi đầu mang tính cách mạng, có nhiều hứa hẹn cho sự phát triển tinh thể silicon. Nguyên tắc tăng trưởng đơn tinh thể bằng (a) phương pháp vùng nổi và (b) Phương pháp Czochralski. (Sau[13.1]) Người ta ước tính rằng khoảng 95%của tất cả silicon đơn tinh thể được sản xuất theo phương pháp CZ và phần còn lại chủ yếu bằng phương pháp FZ. Ngành công nghiệp bán dẫn silicon yêu cầu độ tinh khiết cao và nồng độ khuyết tật tối thiểu trong tinh thể silicon của chúng để tối ưu hóa năng suất sản xuất thiết bị và hiệu suất hoạt động. Những yêu cầu này ngày càng trở nên nghiêm ngặt khi công nghệ thay đổi từ LSI sang VLSI ∕ ULSI và sau đó là SOC. Bên cạnh chất lượng hoặc độ hoàn thiện của tinh thể silicon, đường kính tinh thể cũng đang tăng đều đặn để đáp ứng nhu cầu của các nhà sản xuất thiết bị. Vì chip vi điện tử được sản xuất thông quahệ thống hàng loạt, đường kính của các tấm silicon được sử dụng để chế tạo thiết bị ảnh hưởng đáng kể đến năng suất (như trong Hình.13.2), và lần lượt là chi phí sản xuất. Trong các phần tiếp theo, trước tiên chúng ta thảo luận về phương pháp FZ và sau đó chuyển sang phương pháp CZ. Phần sau sẽ được thảo luận chi tiết hơn do tầm quan trọng của nó đối với ngành vi điện tử. Phương pháp FZ có nguồn gốc từ quá trình nung chảy vùng, được sử dụng để tinh chế các hợp kim nhị phân [13.6] và được phát minh bởiTheuerer[13.7]. Khả năng phản ứng của silicon lỏng với vật liệu được sử dụng cho nồi nấu kim loại đã dẫn đến sự phát triển của phương pháp FZ [13.8], cho phép silic kết tinh mà không cần bất kỳ sự tiếp xúc nào với vật liệu nấu kim loại, cần thiết để có thể phát triển các tinh thể có độ tinh khiết bán dẫn cần thiết. Trong quá trình FZ, thanh apolysilicon được chuyển đổi thành thỏi tinh thể độc tôn bằng cách đi qua vùng amolten được làm nóng bởi cuộn dây mắt thần từ đầu này sang đầu kia của thanh, như thể hiện trong Hình.13.3a. Đầu tiên, đầu của thanh polysilicon được tiếp xúc và hợp nhất với tinh thể hạt có hướng tinh thể mong muốn. Quá trình này được gọi làgieo hạt. Vùng nóng chảy có hạt được đưa qua thanh polysilicon bằng cách đồng thời di chuyển hạt đơn tinh thể xuống dưới thanh. Khi vùng nóng chảy của silic đông đặc, polysilicon được chuyển thành silic đơn tinh thể với sự trợ giúp của tinh thể hạt. Khi vùng di chuyển dọc theo thanh polysilicon, silicon đơn tinh thể đóng băng ở phần cuối của nó và phát triển như một phần mở rộng của tinh thể hạt. X-ray địa hình của hạt, cổ và phần hình nón của silicon vùng nổi. (Được sự cho phép của Tiến sĩ T. Abe) Hệ thống hỗ trợ cho tinh thể silicon vùng nổi. (Sau[13.9]) Để thu được các đơn tinh thể silic loại n hoặc p có điện trở suất cần thiết, polysilicon hoặc tinh thể đang phát triển phải được pha tạp tương ứng với các tạp chất cho hoặc nhận thích hợp. Đối với sự phát triển của silicon FZ, mặc dù một số kỹ thuật pha tạp đã được thử, các tinh thể này thường được pha tạp bằng cách thổi khí thông qua như phosphine (PH3) đối với silicon hoặc diborane loại n (B2H6) cho silicon loại p vào vùng nóng chảy. Khí dopant thường được pha loãng với khí acarrier, chẳng hạn như argon. Ưu điểm lớn của phương pháp này là nhà sản xuất tinh thể silicon không cần lưu trữ các nguồn polysilicon có điện trở suất khác nhau. Ứng dụng của NTD hầu như chỉ giới hạn ở tinh thể FZ vì độ tinh khiết của chúng cao hơn so với tinh thể CZ. Khi kỹ thuật NTD được áp dụng cho các tinh thể silicon CZ, người ta nhận thấy rằng sự hình thành chất cho oxy trong quá trình ủ sau khi chiếu xạ đã thay đổi điện trở suất so với dự kiến, mặc dù đã đạt được sự đồng nhất của chất cho phốt pho [13.11]. NTD có một thiếu sót nữa là không có quy trình nào có sẵn cho thuốc chống thấm loại p và cần thời gian chiếu xạ quá lâu để có điện trở suất thấp (trong khoảng 1–10 Ω cm). Trong quá trình phát triển tinh thể FZ, silicon nóng chảy không tiếp xúc với bất kỳ chất nào ngoài khí xung quanh trong buồng tăng trưởng. Do đó, tinh thể silicon FZ vốn đã được phân biệt bởi độ tinh khiết cao hơn so với tinh thể aCZ được phát triển từ quá trình nung chảy - liên quan đến việc tiếp xúc với chén thủy tinh. Sự tiếp xúc này làm tăng nồng độ tạp chất oxy cao khoảng 1018nguyên tử ∕ cm3trong tinh thể CZ, trong khi silicon FZ chứa ít hơn 1016nguyên tử ∕ cm3. Độ tinh khiết cao hơn này cho phép silicon FZ đạt được điện trở suất cao không thể đạt được khi sử dụng silicon CZ. Hầu hết silicon FZ được tiêu thụ có điện trở suất từ 10 đến 200 Ω cm, trong khi silicon CZ thường được chuẩn bị cho điện trở suất từ 50 Ω cm trở xuống do nhiễm bẩn từ chén thạch anh. Do đó, silicon FZ chủ yếu được sử dụng để chế tạo các thiết bị điện bán dẫn hỗ trợ điện áp ngược vượt quá 750–1000 V. Sự phát triển tinh thể có độ tinh khiết cao và các đặc tính pha tạp chính xác của NTD FZ-Si cũng đã dẫn đến việc sử dụng nó trong các máy dò hồng ngoại [13.12], ví dụ. Tuy nhiên, nếu chúng ta xem xét độ bền cơ học, đã được công nhận trong nhiều năm rằng silicon FZ, chứa ít tạp chất oxy hơn silicon CZ, yếu hơn về mặt cơ học và dễ bị ứng suất nhiệt hơn trong quá trình chế tạo thiết bị [13.13,13.14]. Xử lý ở nhiệt độ cao của các tấm silicon trong quá trình sản xuất thiết bị điện tử thường tạo ra ứng suất nhiệt đủ để tạo ra hiện tượng trượt và cong vênh. Những hiệu ứng này làm giảm năng suất do các mối nối bị rò rỉ, khuyết tật điện môi và giảm tuổi thọ, cũng như giảm năng suất quang điện tử do độ phẳng của tấm wafer bị suy giảm. Mất độ phẳng hình học do cong vênh có thể nghiêm trọng đến mức các tấm wafer không được xử lý thêm. Bởi vì điều này, tấm silicon CZ đã được sử dụng rộng rãi hơn nhiều trong chế tạo thiết bị vi mạch so với tấm FZ. Sự khác biệt về độ ổn định cơ học chống lại ứng suất nhiệt này là lý do chính tại sao các tinh thể silicon CZ được sử dụng riêng để chế tạo các vi mạch yêu cầu số lượng báo động của các bước quy trình nhiệt. Để khắc phục những khuyết điểm này của silicon FZ, sự phát triển của các tinh thể silicon FZ với các tạp chất pha tạp như oxy [13.15] và nitơ [13.16] đã được cố gắng. Người ta phát hiện ra rằng pha tạp tinh thể silicon FZ với oxy hoặc nitơ ở nồng độhoặc là, tương ứng, dẫn đến sự gia tăng đáng kể về độ bền cơ học. Phương pháp này được đặt theo tên của J. Czochralski, người đã thiết lập atechnique để xác định vận tốc kết tinh của kim loại [13.17]. Tuy nhiên, phương pháp kéo thực tế đã được áp dụng rộng rãi để tăng trưởng đơn tinh thể được phát triển bởiMàu mòng kétvàÍt[13.18], người đã sửa đổi nguyên tắc cơ bản của Czochralski. Họ là những người đầu tiên phát triển thành công các đơn tinh thể của gecmani, dài 8 inch và đường kính 0,75 inch, vào năm 1950. Sau đó, họ thiết kế một bộ máy khác để phát triển silicon ở nhiệt độ cao hơn. Mặc dù quy trình sản xuất cơ bản đối với silicon đơn tinh thể đã thay đổi rất ít kể từ khi nó được Teal và các đồng nghiệp đi tiên phong, nhưng silicon đơn tinh thể có đường kính lớn (lên đến 400 mm) với mức độ hoàn thiện cao đáp ứng các thiết bị hiện đại nhu cầu đã được tăng lên bằng cách kết hợp kỹ thuật Dash và những đổi mới công nghệ liên tiếp vào bộ máy. Các nỗ lực nghiên cứu và phát triển ngày nay liên quan đến tinh thể silicon đều hướng tới việc đạt được sự đồng nhất về mặt vi mô của các đặc tính tinh thể như điện trở suất và nồng độ của các tạp chất và vi sai, cũng như việc kiểm soát chúng bằng kính hiển vi, sẽ được thảo luận ở phần khác trong Sổ tay này. 1. Các khối hoặc hạt polysilicon được đặt trong chén nung aquartz và nấu chảy ở nhiệt độ cao hơn nhiệt độ nóng chảy của silicon (1420∘C) trong môi trường khí trơ. 2. Quá trình tan chảy được giữ ở nhiệt độ cao trong một thời gian để đảm bảo tan chảy hoàn toàn và đẩy ra các bong bóng nhỏ, có thể gây ra khoảng trống hoặc khuyết tật tinh thể âm, từ quá trình nấu chảy. 3. Tinh thể đã được làm lạnh với hướng tinh thể mong muốn được nhúng vào nồi nấu chảy cho đến khi nó bắt đầu tự tan chảy. Sau đó, hạt được rút ra khỏi sự tan chảy để hình thành phần cổ bằng cách giảm dần đường kính; đây là bước tinh tế nhất. Trong toàn bộ quá trình tăng trưởng tinh thể, khí trơ (thường là argon) chảy xuống qua buồng kéo để mang theo các sản phẩm phản ứng như SiO và CO. 4. Bằng cách tăng dần đường kính tinh thể, phần hình nón và phần vai được phát triển. Đường kính được tăng lên đến đường kính mục tiêu bằng cách giảm tốc độ kéo và ∕ hoặc nhiệt độ nóng chảy. 5. Cuối cùng, phần hình trụ của cơ thể có đường kính xuyên thấu được phát triển bằng cách kiểm soát tốc độ kéo và nhiệt độ nóng chảy trong khi bù đắp cho sự sụt giảm mức độ nóng chảy khi tinh thể lớn lên. Tốc độ kéo thường bị giảm về phía đuôi của tinh thể đông cứng, chủ yếu là do bức xạ nhiệt ngày càng tăng từ thành chén khi mức độ nóng chảy giảm xuống và để lộ nhiều thành chén hơn với tinh thể đang lớn. Gần cuối của quá trình tăng trưởng, nhưng trước khi nồi nấu hết silic nóng chảy, đường kính tinh thể phải được giảm dần để tạo thành hình nón cuối nhằm giảm thiểu sốc nhiệt, có thể gây ra trật khớp trượt ở đầu đuôi. Khi đường kính trở nên đủ nhỏ, tinh thể có thể được tách ra khỏi sự nóng chảy mà không tạo ra sự lệch lạc. Hình ảnh sơ đồ của hệ thống nuôi cấy tinh thể silicon Czochralski điển hình. (Sau[13.1]) Phần cuối hạt của tinh thể silicon Czochralski đang phát triển Thỏi silicon Czochralski cực lớn khi trưởng thành có đường kính 400 mm và chiều dài 1800 mm. (Được sự cho phép của Tập đoàn Viện Nghiên cứu Tinh thể Super Silicon, Nhật Bản) Môi trường nhiệt trong quá trình phát triển tinh thể Czochralski ở giai đoạn đầu và giai đoạn cuối.Mũi tênchỉ ra các hướng gần đúng của dòng nhiệt. (Sau[13.19]) Ngoài ra, sự phân bố không đồng đều của cả khuyết tật tinh thể và tạp chất xảy ra trên mặt cắt ngang của tấm wafer aflat được chuẩn bị từ silicon nóng chảy tinh thể aCZ được kết tinh hoặc đông đặc liên tiếp tại giao diện tinh thể-tan chảy, thường cong trong quá trình tăng trưởng tinh thể CZ. Những bất đồng nhất như vậy có thể được quan sát nhưkhoảng cách, sẽ được thảo luận sau. Đặc tính của chất bán dẫn silicon được sử dụng trong các thiết bị điện tử là rất nhạy cảm với các tạp chất. Do độ nhạy này, các đặc tính điện - điện tử của silicon có thể được kiểm soát chính xác bằng cách thêm lượng nhỏ dopant. Ngoài độ nhạy dopant này, sự nhiễm bẩn bởi các tạp chất (đặc biệt là các kim loại chuyển tiếp) ảnh hưởng tiêu cực đến các đặc tính của silicon và dẫn đến sự suy giảm nghiêm trọng hiệu suất của thiết bị. Hơn nữa, oxy được kết hợp ở mức hàng chục nguyên tử trên triệu vào các tinh thể silicon CZ do phản ứng giữa silicon nóng chảy và chén thạch anh. Bất kể lượng oxy trong tinh thể là bao nhiêu, các đặc tính của tinh thể silic bị ảnh hưởng rất nhiều bởi nồng độ và hoạt động của oxy [13.21]. Ngoài ra, cacbon cũng được kết hợp vào các tinh thể CZ silicon từ nguyên liệu thô polysilicon hoặc trong quá trình tăng trưởng, do các bộ phận graphit được sử dụng trong thiết bị kéo CZ. Mặc dù nồng độ carbon trong tinh thể silicon CZ thương mại thường nhỏ hơn 0,1 ppma, nhưng carbon là một tạp chất ảnh hưởng lớn đến hoạt động của oxy [13.22,13.23]. Ngoài ra, các tinh thể silicon CZ pha tạp nitơ [13.24,13.25] gần đây đã thu hút nhiều sự chú ý do chất lượng tinh thể cực nhỏ của chúng, có thể đáp ứng các yêu cầu đối với các thiết bị điện tử hiện đại [13.26,13.27]. Trong quá trình kết tinh từ amelt, các tạp chất khác nhau (bao gồm cả chất pha tạp) chứa trong chất tan chảy được kết hợp vào tinh thể đang phát triển. Nồng độ tạp chất của pha rắn thường khác với nồng độ của pha lỏng do hiện tượng áp suất được gọi làsự tách biệt. Hành vi phân ly cân bằng liên quan đến sự đông đặc của các hệ thống đa thành phần có thể được xác định từ biểu đồ pha tương ứng của hệ thống dị thường vớitan(tạp chất) và adung môi(vật liệu chủ) như các thành phần. Do đó, rõ ràng là sự thay đổi theo chiều dọc amacroscopic của mức tạp chất, gây ra sự thay đổi điện trở suất do sự thay đổi nồng độ dopant, là cố hữu của quá trình tăng trưởng lô CZ; điều này là do hiện tượng phân ly. Hơn nữa, sự phân bố theo chiều dọc của các tạp chất bị ảnh hưởng bởi những thay đổi về độ lớn và bản chất của đối lưu nóng chảy xảy ra khi tỷ lệ nóng chảy giảm trong quá trình phát triển của tinh thể. Các khoảng cách tăng trưởng, được tiết lộ bằng cách ăn mòn hóa học, trong vạc bằng silicon Czochralski Sự cố về mặt vật lý gây ra bởi sự tách biệt của các tạp chất và các khuyết tật điểm; tuy nhiên, các vân trên thực tế được gây ra bởi sự dao động nhiệt độ gần mặt phân cách tinh thể-tan chảy, gây ra bởi sự đối lưu nhiệt không ổn định trong quá trình nóng chảy và quay tinh thể trong môi trường nhiệt không đối xứng. Ngoài ra, các rung động cơ học do cơ chế kiểm soát kéo kém trong thiết bị tăng trưởng cũng có thể gây ra dao động nhiệt độ. Sơ đồ minh họa mặt cắt ngang của tinh thể Czochralski chứa giao diện pha lê tan chảy và phiến phẳng được cắt thành các phần khác nhau. (Sau[13.1]) Để có được điện trở suất mong muốn, một lượng dopant nhất định (nguyên tử cho hoặc nguyên tử nhận) được thêm vào asilicon nóng chảy theo quan hệ điện trở suất - nồng độ. Thực tế phổ biến là thêm chất pha tạp ở dạng hạt hoặc khối silicon pha tạp nhiều có điện trở suất khoảng 0,01 Ω cm, được gọi là chất cố định dopant, vì lượng dopant nguyên chất cần thiết là nhỏ không thể quản lý được, ngoại trừ vật liệu silicon pha tạp nhiều (n+hoặc p+silicon). 1. Mức năng lượng phù hợp 2. Độ hòa tan cao 3. Độ khuếch tán phù hợp hoặc thấp 4. Áp suất hơi thấp. Sự kết hợp oxy và carbon vào tinh thể silicon Czochralski. (Sau[13.1]) 1. Đường kính lớn 2. Mật độ khuyết tật thấp hoặc được kiểm soát 3. Gradient điện trở suất xuyên tâm đồng nhất và thấp 4. Nồng độ oxy ban đầu tối ưu và lượng mưa của nó. Dòng đối lưu nóng chảy trong chén ảnh hưởng mạnh đến chất lượng tinh thể của silicon CZ. Đặc biệt, sự chênh lệch sinh trưởng không thuận lợi được gây ra bởi sự đối lưu nóng chảy không ổn định dẫn đến sự dao động nhiệt độ ở bề mặt sinh trưởng. Khả năng của từ trường để ức chế đối lưu nhiệt trong chất lỏng dẫn điện lần đầu tiên được áp dụng cho sự phát triển tinh thể của antimonide indium thông qua kỹ thuật thuyền ngang [13.28] và kỹ thuật làm tan vùng ngang [13.29]. Thông qua những nghiên cứu này, người ta đã xác nhận rằng từ trường có cường độ đủ mạnh có thể ngăn chặn sự dao động nhiệt độ đi kèm với đối lưu nóng chảy, và có thể làm giảm đáng kể các vân tăng trưởng. Ảnh hưởng của từ trường lên các vân tăng trưởng được giải thích bằng khả năng làm giảm sự đối lưu nhiệt hỗn loạn của amelt và lần lượt làm giảm các dao động nhiệt độ tại mặt phân cách tinh thể-tan chảy. Sự cản trở dòng chất lỏng gây ra bởi từ trường là do lực từ động gây ra khi dòng chảy trực giao với các đường sức từ, làm tăng độ nhớt động học hiệu dụng của chất dẫn nóng chảy. Sự phát triển tinh thể silic bằng phương pháp CZ (MCZ) từ trường được áp dụng lần đầu tiên được báo cáo vào năm 1980 [13.30]. Ban đầu MCZ được thiết kế cho sự phát triển của các tinh thể CZ silicon có chứa nồng độ oxy thấp và do đó có điện trở suất cao với sự biến đổi xuyên tâm thấp. Nói cách khác, MCZ silicon được kỳ vọng sẽ thay thế silicon FZ hầu như chỉ được sử dụng để chế tạo thiết bị điện. Kể từ đó, các cấu hình từ trường khác nhau, về hướng từ trường (ngang hoặc dọc) và loại nam châm được sử dụng (dẫn điện bình thường hoặc siêu dẫn), đã được phát triển [13.31]. MCZ silicon được sản xuất với nhiều phạm vi nồng độ oxy mong muốn (từ thấp đến cao) đã được quan tâm nhiều cho các ứng dụng thiết bị khác nhau. Giá trị của MCZ silicon nằm ở chất lượng cao và khả năng kiểm soát nồng độ oxy trên phạm vi awide, điều mà phương pháp CZ thông thường không thể đạt được [13.32], cũng như tốc độ tăng trưởng nâng cao của nó [13.33]. Về chất lượng tinh thể có liên quan, chắc chắn rằng phương pháp MCZ cung cấp các tinh thể silicon thuận lợi nhất cho ngành công nghiệp thiết bị bán dẫn. Chi phí sản xuất của MCZ silicon có thể cao hơn so với silicon CZ thông thường vì phương pháp MCZ tiêu thụ nhiều năng lượng điện hơn và yêu cầu thêm thiết bị và không gian hoạt động cho nam châm điện; tuy nhiên, có tính đến tốc độ phát triển cao hơn của MCZ và khi sử dụng nam châm siêu dẫn cần không gian nhỏ hơn và tiêu thụ ít điện năng hơn so với nam châm dẫn điện, chi phí sản xuất của tinh thể silicon MCZ có thể tương đương với chi phí sản xuất tinh thể silicon CZ thông thường. Ngoài ra, chất lượng tinh thể được cải thiện của MCZ silicon có thể làm tăng năng suất sản xuất và hạ giá thành sản phẩm. Chi phí sản xuất tinh thể phụ thuộc vào mức độ đáng báo động của chi phí vật liệu, đặc biệt là chi phí của những vật liệu được sử dụng cho nồi nấu kim loại thạch anh. Trong quy trình CZ thông thường, được gọi làquá trình thực thi, acrystal được kéo ra từ điện tích của chén nung kim loại, và chén nung bằng thạch anh chỉ được sử dụng một lần và sau đó được loại bỏ. Điều này là do một lượng nhỏ silicon còn lại làm nứt nồi nấu khi nó nguội đi từ nhiệt độ cao trong mỗi lần tăng trưởng. Một điều quan trọng nhất để bổ sung nước nấu chảy aquartz một cách kinh tế là liên tục thêm thức ăn khi tinh thể lớn lên và do đó duy trì sự tan chảy ở thể tích bất thường. Ngoài việc tiết kiệm chi phí nấu kim loại, phương pháp Czochralski (CCZ) sạc liên tục cung cấp một môi trường lý tưởng cho sự phát triển của tinh thể silicon. Như đã đề cập, nhiều sự không đồng nhất trong các tinh thể được nuôi cấy bằng quy trình lô CZ thông thường là kết quả trực tiếp của động học không ổn định phát sinh từ sự thay đổi thể tích nóng chảy trong quá trình tăng trưởng của tinh thể. Phương pháp CCZ không chỉ nhằm mục đích giảm chi phí sản xuất mà còn để nuôi cấy tinh thể trong điều kiện ổn định. Bằng cách duy trì thể tích nóng chảy ở mức không hòa tan, có thể đạt được các điều kiện nhiệt và dòng chảy ổn định (xem Hình.13.9, cho thấy sự thay đổi của môi trường nhiệt trong quá trình tăng trưởng CZ thông thường). Sơ đồ minh họa của phương pháp Czochralski sạc liên tục. (Sau[13.34]) Phương pháp CCZ chắc chắn giải quyết được hầu hết các vấn đề liên quan đến tính không đồng nhất trong tinh thể được nuôi cấy bằng phương pháp CZ thông thường. Hơn nữa, sự kết hợp của MCZ và CCZ (CZ liên tục ứng dụng từ trường (MCCZ) phương pháp) dự kiến sẽ cung cấp phương pháp tăng trưởng tinh thể cuối cùng, tạo ra các tinh thể silicon lý tưởng cho nhiều ứng dụng vi điện tử [13.1]. Thật vậy, nó đã được sử dụng để phát triển các tinh thể silicon chất lượng cao dành cho các thiết bị vi điện tử [13.35]. Tuy nhiên, cần nhấn mạnh rằng lịch sử nhiệt khác nhau của các phần khác nhau của tinh thể (từ hạt đến đầu đuôi, như trong Hình.13.9) phải được xem xét ngay cả khi tinh thể được nuôi cấy bằng phương pháp tăng trưởng lý tưởng. Để đồng nhất tinh thể lớn lên hoặc để có được sự đồng nhất dọc trục trong lịch sử nhiệt, một số hình thức xử lý sau, chẳng hạn như ủ nhiệt độ cao [13.36], là bắt buộc đối với tinh thể. Như đã đề cập trước đây, quá trình thắt cổ của Dash (phát triển ở cổ có đường kính 3-5 mm, Hình.13.7) là bước quan trọng trong quá trình tăng trưởng tinh thể CZ vì nó loại bỏ các sai lệch phát triển trong. Kỹ thuật này đã là tiêu chuẩn của ngành trong hơn 40 năm. Tuy nhiên, nhu cầu gần đây đối với đường kính tinh thể lớn (& gt; 300 mm, nặng hơn 300 kg) đã dẫn đến nhu cầu về cổ có đường kính lớn hơn mà không gây ra sự lệch lạc vào tinh thể ngày càng tăng, vì cổ nhỏ có đường kính 3-5 mm không thể hỗ trợ các tinh thể lớn như vậy. Tinh thể silicon Czochralski không bị lệch đường kính 200 mm được trồng mà không cần quá trình thắt cổ Dash. (a)Cả người, (b) hạt và hình nón. (Được sự cho phép của GS K. Hoshikawa) 13,1F. Shimura:Công nghệ tinh thể silicon bán dẫn(Học thuật, New York 1988)Google Scholar 13.2WC Dash: J. Appl. Thể chất.29, 736 (1958)CrossRefGoogle Scholar 13.3K.Takada, H.Yamagishi, H.Minami, M.Imai: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1998) tr.376Google Scholar 13.4JRMcCormic: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1986) tr.43Google Scholar 13.5PA Taylor: Technol trạng thái rắn.Tháng bảy, 53 (1987)Google Scholar 13,6WG Pfann: Chuyển đổi. Là. Phiên bản Min. Metall. Tiếng Anh194, 747 (1952)Google Scholar 13.7CH Người cấp: Bằng sáng chế Hoa Kỳ 3060123 (1962)Google Scholar 13,8PH Keck, MJE Golay: Phys. Rev.89, 1297 (1953)CrossRefGoogle Scholar 13,9W. Keller, A. Mühlbauer:Silicon-Zone FLoating(Marcel Dekker, New York 1981)Google Scholar 13,10JM Meese:Doping biến đổi nơtron trong chất bán dẫn(Plenum, New York 1979)CrossRefGoogle Scholar 13.11HMLiaw, CJVarker: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1977) tr.116Google Scholar 13.12ELKern, LSYaggy, JABarker: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1977) tr.52Google Scholar 13.13SM Hu: Appl. Thể chất. Lett.31, 53 (1977)CrossRefGoogle Scholar 13,14 nghìn. Sumino, H. Harada, I. Yonenaga: Jpn. J. Appl. Thể chất.19, L49 (1980)CrossRefGoogle Scholar 13,15 nghìn. Sumino, I. Yonenaga, A. Yusa: Jpn. J. Appl. Thể chất.19, L763 (1980)CrossRefGoogle Scholar 13.16T.Abe, K.Kikuchi, S.Shirai: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1981) tr.54Google Scholar 13,17J. Czochralski: Z. Phys. Chèm.92, 219 (1918)Google Scholar 13,18GK Teal, JB Little: Phys. Rev.78, 647 (1950)Google Scholar 13,19W. Zulehner, D. Huber: Trong:Crystals 8: Silicon, Hóa chất khắc(Springer, Berlin, Heidelberg 1982) tr. 1Google Scholar 13,20 giờ. Tsuya, F. Shimura, K. Ogawa, T. Kawamura: J. Electrochem. Soc.129, 374 (1982)CrossRefGoogle Scholar 13,21F. Shimura (Ed.):Oxy trong Silicon(Học thuật, New York 1994)Google Scholar 13,22S. Kishino, Y. Matsushita, M. Kanamori: Appl. Thể chất. Lett.35, 213 (1979)CrossRefGoogle Scholar 13,23F. Shimura: J. Appl. Thể chất.59, 3251 (1986)CrossRefGoogle Scholar 13,24HD Chiou, J. Moody, R. Sandfort, F. Shimura: Công nghệ khoa học VLSI, Proc. Int. Thứ 2 Symp. Quy mô rất lớn Integr. (Hiệp hội Điện hóa, Pennington 1984) tr. 208Google Scholar 13,25F. Shimura, RS Hocket: Appl. Thể chất. Lett.48, 224 (1986)CrossRefGoogle Scholar 13,26A.Huber, M.Kapser, J.Grabmeier, U.Lambert, WvAmmon, R.Pech: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 2002) tr.280Google Scholar 13,27GARozgonyi: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 2002) tr.149Google Scholar 13,28HP Utech, MC Flemings: J. Appl. Thể chất.37, 2021 (1966)CrossRefGoogle Scholar 13,29HA Chedzey, DT Hurtle: Nature210, 933 (1966)CrossRefGoogle Scholar 13,30 K.Hoshi, T.Suzuki, Y.Okubo, N.Isawa: Ext. Tóm tắt Điện hóa. Soc. Lần gặp thứ 157. (Hiệp hội Điện hóa, Pennington 1980) tr.811Google Scholar 13,31M.Ohwa, T.Higuchi, E.Toji, M.Watanabe, K.Homma, S.Takasu: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1986) tr.117Google Scholar 13,32 triệu.Futagami, K.Hoshi, N.Isawa, T.Suzuki, Y.Okubo, Y.Kato, Y.Okamoto: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1986) tr.939Google Scholar 13,33T.Suzuki, N.Isawa, K.Hoshi, Y.Kato, Y.Okubo: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1986) tr.142Google Scholar 13,34W.Zulehner: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1990) tr.30Google Scholar 13,35Y.Arai, M.Kida, N.Ono, K.Abe, N.Machida, H.Futuya, K.Sahira: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1994) tr.180Google Scholar 13,36F. Shimura: Trong:Khoa học và Công nghệ VLSI(Hiệp hội Điện hóa, Pennington 1982) tr. 17Google Scholar 13,37S.Chandrasekhar, KMKim: Trong:Silicon bán dẫn(Hiệp hội Điện hóa, Pennington 1998) tr.411Google Scholar 13,38 nghìn. Hoshikawa, X. Huang, T. Taishi, T. Kajigaya, T. Iino: Jpn. J. Appl. Thể chất.38, L1369 (1999)CrossRefGoogle Scholar 13,39KM Kim, P. Smetana: J. Cryst. sự phát triển100, 527 (1989)CrossRefGoogle Scholar13.1Tổng quat
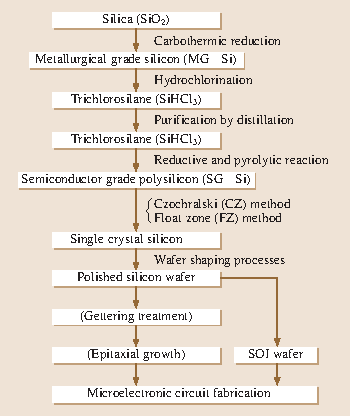
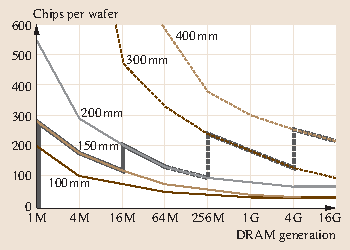
13.2Nguyên liệu ban đầu
13.2.1Silicon cấp luyện kim
Nguyên liệu ban đầu cho các đơn tinh thể silicon có độ tinh khiết cao là silica (SiO2). Bước đầu tiên trong sản xuất silicon là nấu chảy và khử silica. Điều này được thực hiện bằng cách trộn silica và carbon ở dạng than, than cốc hoặc dăm gỗ và nung hỗn hợp đến nhiệt độ cao trong lò hồ quang điện cực không nung. Quá trình khử cacbother này của silica tạo ra silicon nóng chảy13.2.2Silicon đa tinh thể
Hợp chất hóa học trung gian
Hiđro hóa silic
Trichlorosilane được tổng hợp bằng cách nung MG-Si dạng bột ở khoảng 300∘C trong lò phản ứng tầng afluidized. Tức là MG-Si được chuyển thành SiHCl3theo phản ứng sauChưng cất và phân hủyTrichlorosilane
Chưng cất đã được sử dụng rộng rãi để tinh chế trichlorosilan. Trichlorosilan, có nhiệt độ sôi cao (31,8∘C), được chưng cất từng phần từ các halogenua không tinh khiết, dẫn đến độ tinh khiết tăng lên rất nhiều, với nồng độ tạp chất hoạt động điện nhỏ hơn 1 ppba. Sau đó, trichlorosilan có độ tinh khiết cao được làm bay hơi, pha loãng với hydro độ tinh khiết cao và được đưa vào lò phản ứng lắng đọng. Trong lò phản ứng, các thanh silicon mỏng được gọi là thanh mỏng được hỗ trợ bởi các điện cực graphit có sẵn để lắng đọng bề mặt của silicon theo phản ứngQuy trình Monosilane
Lắng đọng polysilicon dạng hạt
13.3Tăng trưởng đơn tinh thể
Mặc dù nhiều kỹ thuật khác nhau đã được sử dụng để chuyển polysilicon thành đơn tinh thể silicon, hai kỹ thuật đã thống trị việc sản xuất chúng cho điện tử vì chúng đáp ứng các yêu cầu của ngành thiết bị vi điện tử. Một là phương pháp làm tan chảy azone thường được gọi làvùng nổi (FZ) phương phápvà phương pháp khác là phương pháp apulling theo truyền thống được gọi làCzochralski (CZ) phương pháp, mặc dù nó thực sự nên được gọi làPhương pháp Teal – Little. Các nguyên tắc đằng sau hai phương pháp tăng trưởng tinh thể này được mô tả trong Hình.13.3. Trong phương pháp FZ, vùng amolten được đưa qua thanh apolysilicon để chuyển nó thành thỏi tinh thể độc tôn; trong phương pháp CZ, tinh thể asingle được phát triển bằng cách kéo từ amelt chứa trong chén nung aquartz. Trong cả hai trường hợp,hạt giống tinh thểđóng một vai trò rất quan trọng trong việc thu được tinh thể vô sắc với định hướng tinh thể học mong muốn.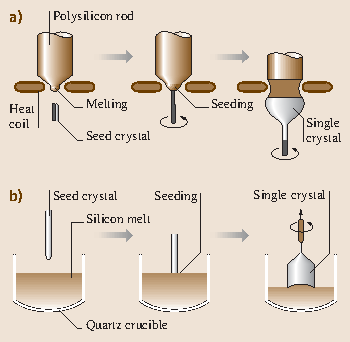
13.3.1Phương pháp vùng nổi
Nhận xét chung
Sơ lược về quy trình

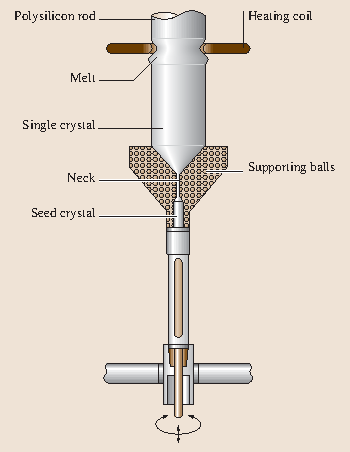
Doping
Tính chất của tinh thể FZ-Silicon
13.3.2Phương pháp Czochralski
Nhận xét chung
Sơ lược về quy trình
Ba bước quan trọng nhất trong quá trình tăng trưởng tinh thể CZ được thể hiện dưới dạng giản đồ trong Hình.13.3b. Về nguyên tắc, quá trình tăng trưởng CZ tương tự như quá trình tăng trưởng FZ: (1) polysilicon tan chảy, (2) gieo hạt và (3) phát triển. Tuy nhiên, quy trình kéo CZ phức tạp hơn so với quy trình tăng trưởng FZ và được phân biệt với nó bằng cách sử dụng chén aquartz để chứa silicon nóng chảy. Nhân vật13.6cho thấy chế độ xem aschematic của thiết bị tăng trưởng tinh thể CZ hiện đại điển hình. Các bước quan trọng trong trình tự phát triển tinh thể silicon CZ thực tế hoặc tiêu chuẩn như sau:
Nhân vật13.7cho thấy phần cuối hạt của tinh thể silicon CZ đang phát triển. Mặc dù hạt ngô, là vùng chuyển tiếp từ hạt sang phần hình trụ, thường được hình thành khá bằng phẳng vì lý do kinh tế, nhưng hình dạng thon hơn có thể mong muốn theo quan điểm chất lượng acrystal. Phần vai và vùng lân cận không nên được sử dụng để chế tạo thiết bị vì phần này được coi là vùng chuyển dịch theo nhiều nghĩa và nó thể hiện các đặc tính tinh thể không đồng nhất do sự thay đổi đột ngột trong điều kiện sinh trưởng.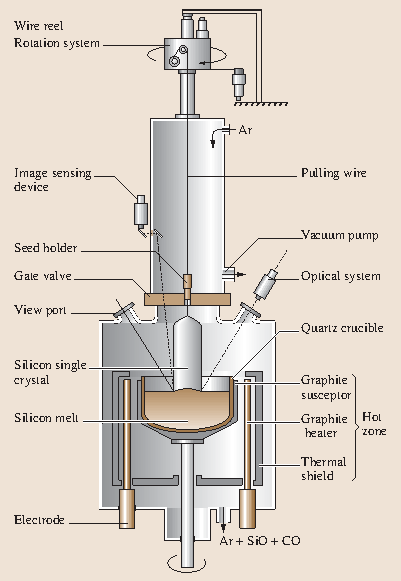
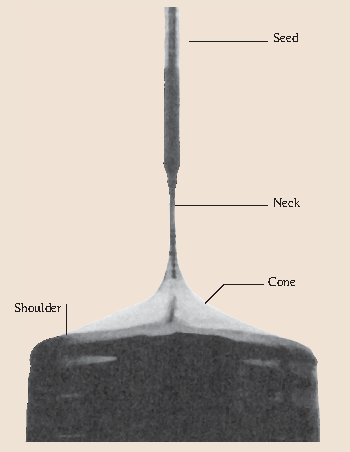

Ảnh hưởng của Vị trí không gian inaGrownCrystal
Như hình.13.9mô tả rõ ràng, mỗi phần của tinh thể aCZ được phát triển ở những thời điểm khác nhau với các điều kiện phát triển khác nhau [13.19]. Vì vậy, điều quan trọng là phải hiểu rằng mỗi phần có tập hợp các đặc điểm tinh thể khác nhau và lịch sử nhiệt khác nhau do vị trí khác nhau của nó dọc theo chiều dài tinh thể. Ví dụ, phần đầu hạt có lịch sử nhiệt dọc theo, nằm trong khoảng từ điểm nóng chảy 1420 đến khoảng 400∘C trong apuller, trong khi phần đuôi có lịch sử ashorter và được làm nguội khá nhanh từ điểm nóng chảy. Cuối cùng, mỗi tấm silicon được điều chế từ một phần khác nhau của tinh thể agrown có thể thể hiện các đặc điểm lý hóa khác nhau tùy thuộc vào vị trí của nó trong thỏi. Trên thực tế, người ta đã báo cáo rằng hành vi kết tủa oxy thể hiện sự phụ thuộc vào vị trí lớn nhất, do đó, ảnh hưởng đến việc tạo ra các khuyết tật lớn [13.20].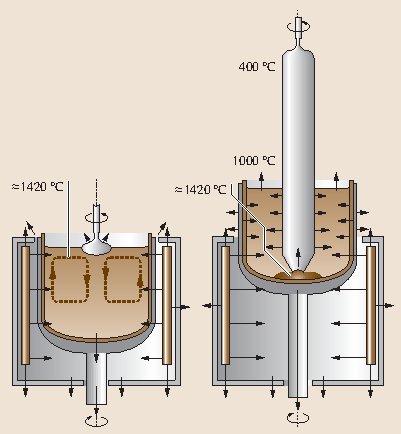
13.3.3Tạp chất trong Czochralski Silicon
Không đồng nhất tạp chất
Tách biệt
Đình công
Trong hầu hết các quá trình tăng trưởng tinh thể, có những quá độ trong các thông số như tốc độ tăng trưởng vi mô tức thời và độ dày lớp ranh giới khuếch tán dẫn đến sự thay đổi trong hệ số phân tách hiệu quảkeff. Những biến thể này làm phát sinh sự không đồng nhất về thành phần vi mô ở dạngkhoảng cáchsong song với mặt phân cách tinh thể-tan chảy. Các dải có thể dễ dàng được xác định bằng một số kỹ thuật, chẳng hạn như khắc hóa học ưu tiên và địa hình tia X. Nhân vật13.10cho thấy các vân được tiết lộ bằng cách ăn mòn hóa học ở phần vai của mặt cắt dọc của tinh thể silicon aCZ. Sự thay đổi dần dần về hình dạng của bề mặt sinh trưởng cũng được quan sát rõ ràng.

Doping
Sự khuếch tán quá cao hoặc áp suất hơi cao dẫn đến sự khuếch tán hoặc hóa hơi không mong muốn của chất pha tạp, dẫn đến hoạt động của thiết bị không ổn định và khó đạt được điều khiển điện trở suất chính xác. Độ bất hòa quá nhỏ sẽ hạn chế điện trở suất có thể nhận được. Ngoài các tiêu chí đó, các đặc tính hóa học (ví dụ độc tính) phải được xem xét. Ngoài ra, xét theo quan điểm của sự phát triển tinh thể là chất pha tạp có hệ số phân ly gần bằng thống nhất để làm cho điện trở suất càng đồng nhất càng tốt từ đầu hạt đến đầu đuôi của thỏi tinh thể CZ. Do đó, phốt pho (P) và bo (B) lần lượt là chất cho và nhận được sử dụng phổ biến nhất cho silic. Đối với n+silic, trong đó các nguyên tử cho được pha tạp nhiều, antimon (Sb) thường được sử dụng thay vì phốt pho vì khả năng khuếch tán nhỏ hơn, mặc dù hệ số phân tách nhỏ và áp suất hơi cao, dẫn đến sự thay đổi lớn về nồng độ trong cả trục và các hướng xuyên tâm.Oxy và Carbon
Như được thể hiện bằng sơ đồ trong Hình.13.3ban nhạc13.6, aquartz (SiO2) các phần tử gia nhiệt bằng chén nung và than chì được sử dụng trong phương pháp tăng trưởng tinh thể CZ-Si. Bề mặt chén tiếp xúc với silicon nóng chảy bị tan dần do phản ứng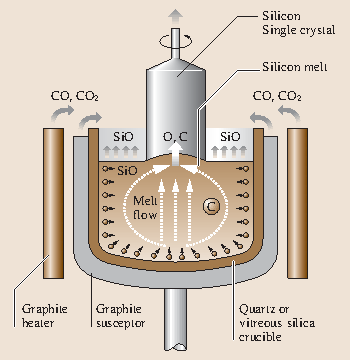
13.4Phương pháp tăng trưởng tinh thể mới
Các tinh thể silic được sử dụng để chế tạo thiết bị vi điện tử phải đáp ứng nhiều yêu cầu do nhà sản xuất thiết bị đặt ra. Ngoài các yêu cầu đối với siliconbánh xốp, các nhu cầu về tinh thể học sau đây đã trở nên phổ biến hơn do sản xuất thiết bị vi điện tử năng suất cao và hiệu suất cao:
Rõ ràng là các nhà sản xuất tinh thể silicon không chỉ phải đáp ứng các yêu cầu trên mà còn phải sản xuất các tinh thể đó một cách kinh tế và có năng suất sản xuất cao. Mối quan tâm chính của những người trồng tinh thể silicon là sự hoàn hảo về mặt tinh thể học và sự phân bố theo trục của các chất pha tạp trong silicon CZ. Để khắc phục một số vấn đề với phương pháp tăng trưởng tinh thể CZ thông thường, một số phương pháp tăng trưởng tinh thể mới đã được phát triển.13.4.1Czochralski Growth withanAppliedMagneticField (MCZ)
13.4.2Phương pháp Czochralski liên tục (CCZ)

13.4.3Phương pháp tăng trưởng không vết mổ
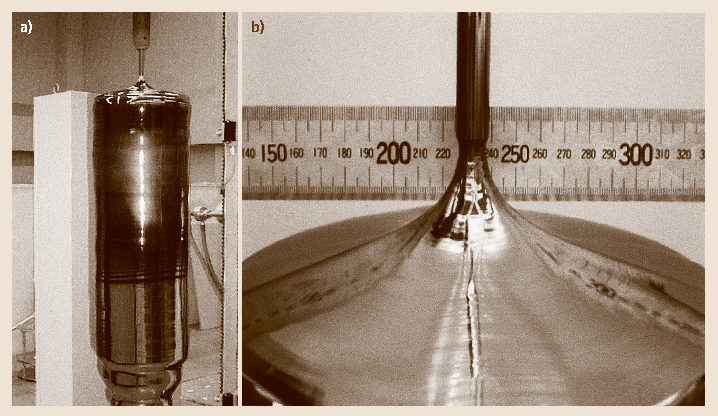
Người giới thiệu

















